
随着半导体技术的飞速发展,硅基集成电路元器件的特征尺寸逐步减小,为人们带来了处理速度更快、能耗更小、成本更低的工业与消费电子产品。然而,随着器件尺寸的减小,作为传统栅介质层的SiO2厚度也会减小,当其减小到原子尺寸时,由于量子隧穿效应的影响,SiO2将失去介电性能,致使器件无法正常工作,使用寿命大幅缩短。高介电常数材料如HfO2的引入与研发,助力元器件尺寸进一步突破了极限,其中叠层HfO2/SiO2/Si栅介质相比于单纯SiO2栅介质具有更高的可靠性,被认为是最有潜力的高介电常数栅介质材料之一。
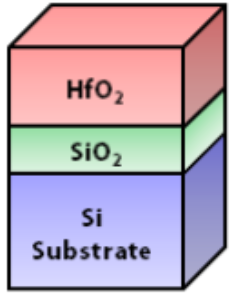
X射线光电子能谱(XPS)技术结合氩离子深度分析已广泛用于研究HfO2/SiO2/Si材料膜层研究,然而刻蚀过程不可避免会导致膜层的破坏以及HfO2的还原,今天小编为大家介绍一种无损的超薄膜层分析技术—角分辨XPS(ARXPS),一起来看下它是如何完美应对吧。
如何实现?
前面我们提到,XPS技术的分析深度取决于出射光电子的非弹性平均自由程,因此可以通过改变光电子的出射角实现不同深度的分析。见下图1所示,通过偏转样品台,使其与能谱仪之间形成夹角,假设样品表面光电子的出射深度d = 80Å,那么偏转θ = 45°夹角后光电子的出射深度则变为dcosθ,即57 Å,相应获得的信息也更靠近外表面,因此我们可以采集不同角度时的XPS结果,实现膜层的分布和厚度的分析。
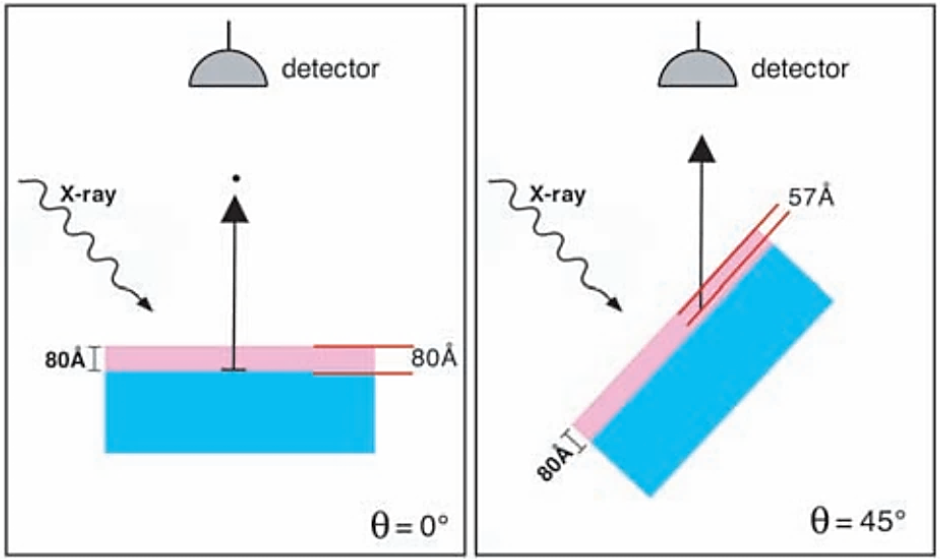
图1 角分辨XPS实现过程
图片来自于《Surface Analysis –The Principal Techniques》
岛津应对之道

岛津ESCApe软件集成最大熵重构方法(MEM),可以对不同角度采集数据执行去卷积的数学处理,根据谱图找到最优解,得到最符合表面元素深度分布的曲线结果,如下例子给出了上图多层膜结构3 nmHfO2/1.5 nmSiO2/Si基底样品的谱图采集及模拟计算结果。图2给出了0°、40°、55°、63°、70°各角度测得的Si 2p谱图,0°时采集深度最大,70°时采集深度最小,可以看出随角度增加Si 2p信号强度降低,这是因为出射角越大,光电子信号深度越靠近表面,信号减弱。Si 2p峰主要由单质态Si及氧化态物种组成,对0°和70°结果进行归一化后可以看出,随角度增大SiO2组分占比明显增加,这说明相对于单质Si,SiO2物种更靠近表面,与样品实际结构相符合。

图2 Si 2p窄谱:左图为0°时Si 2p的拟合结果;右图为不同角度测得的Si 2p窄谱(插图将0°与70°谱图做了归一化处理)
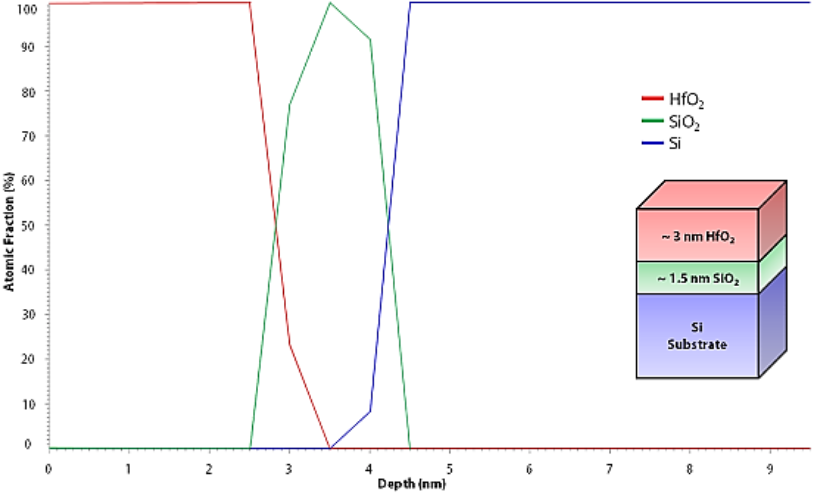
图3 MEM重构得到的深度分析结果
大佬们都在玩{精选官网网址: www.vip333.Co }值得信任的品牌平台!
基于以上采集的不同角度XPS数据,由MEM重构得到的深度分析结果可知,HfO2厚度约为3 nm,SiO2厚度约为1.5 nm,十分接近样品真实信息。
小 结
岛津XPS配备五轴常中心样品台,可以最大程度保证转动过程中测试位置恒定,通过角分辨XPS成功将样品分析深度降低到表面1~3nm。结合MEM重构,完成对薄膜厚度的模拟计算,可以轻松实现表面多层薄膜的无损厚度测定。

版权声明
本文仅代表作者观点,不代表xx立场。
本文系作者授权xxx发表,未经许可,不得转载。










发表评论